2. 新疆电子信息材料与器件重点实验室 乌鲁木齐 830011;
3. 中国科学院大学 北京 100049
2. Xinjiang Key Laboratory of Electronic Information Materials and Devices, Urumqi 830011, China;
3. University of Chinese Academy of Sciences, Beijing 100049, China
双极电压比较器作为一种典型的模拟电路,被广泛用于模数接口、自动控制、电平监测以及波形变化等领域,是空间电子系统中不可或缺的电路之一。然而,工作在空间辐射环境中的双极电压比较器不可避免地受到电离辐射环境的影响,引起晶体管基极电流增大、增益减小等特性,进而严重影响电压比较器电参数,甚至导致电路功能失效[1-2]。研究发现,多数双极器件和电路在低剂量率下的损伤明显大于高剂量率下的损伤,表现出低剂量率辐射损伤增强效应(Enhanced Low Dose Rate Sensitivity, ELDRS)[3-4]。国外针对双极电压比较器的电离辐射效应开展了大量研究工作[5-7],然而这些工作大多是关注电压比较器参数在电离辐射环境下的变化,很少深入探讨比较器电路级的具体退化模式。在国内,本实验室紧随国际步伐,开展了针对双极电压比较器在不同偏置、不同剂量率、同型号不同公司等条件下的辐射效应的探索和研究,取得了诸多研究成果[8-10]。但研究仍然是侧重电压比较器的电学参数在电离辐射环境下的退化,对比较器电路级的损伤机理未做深入分析。针对目前国内外的研究现状,本文选用典型双极电压比较器作为样品,研究了不同偏置状态下电压比较器高低剂量率辐照损伤特性,并深入分析了比较器电路级的具体退化模式。
1 实验样品与方法实验样品为美国德州仪器(Texas Instruments)公司的同批次典型双极电压比较器LM339,电路结构如图 1所示,辐照源为中国科学院新疆理化技术研究所的60Co-γ辐射源,辐照实验采用了两种剂量率条件,即室温辐照的高剂量率(High Dose Rate, HDR) 110rad·s-1 (Si),室温辐照的低剂量率(Low Dose Rate, LDR) 0.01rad·s-1 (Si)。实验中,电压比较器正输入端接电源电压5V,负输入端接地,输出端接10kΩ的上拉电阻。
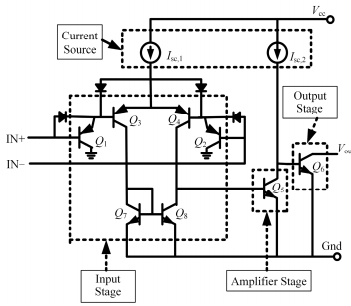
|
图 1 LM339电路结构 Figure 1 Circuit structure of LM339 |
电压比较器高低剂量率的辐射效应和退火特性的研究表明,被测试的器件对电离辐射均相当敏感,并且器件的绝大多数参数均有不同程度的退化,这些电性能参数包括:输入偏置电流、开环增益、输出低电平等,本文将对上述敏感参数的变化规律和电路级的具体退化模式进行详细讨论。
2.1 输入偏置电流在理想情况下,流入电压比较器输入端的电流为零。然而实际上,电压比较器的两个输入端都有电流输入,当偏置电流流过外部阻抗时产生电压,会增大系统误差,它是与输入级有关的特征参数。高低剂量率辐照下的输入偏置电流随总剂量及室温退火的变化如图 2所示。从图 2中可以看出,在不同偏置下比较器的低剂量率辐照损伤均比高剂量率辐照损伤显著,且低剂量率下零偏为最劣偏置。在与低剂量辐照时间相当的室温退火过程中,LM339初期发生微小的损伤恢复,随后趋于稳定。结合退火曲线,虽然器件在退火初期出现略微的减小,但长时间的室温退火并没有消除高低剂量率辐照损伤的显著差异,即表明该电路具有显著的低剂量辐射损伤增强效应。
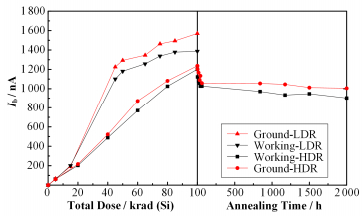
|
图 2 LM339在高低剂量率下输入偏置电流的辐照响应和室温退火行为 Figure 2 Radiation response of input bias current and room-temperature annealing time for LM339 with HDR and LDR |
电压比较器输入偏置电流的变化主要是由电离辐射导致输入级晶体管Q1、Q2的基区表面复合电流Ibsr增加,并且Ibsr变化越大,输入偏置电流的变化也就越大。不同偏置会引起电场分布的差异,即边缘电场和金属电极产生的电场,从而影响由辐射感生的氧化物陷阱电荷和界面陷阱电荷的分布,根据Pershenkov等[11]的研究,对于PNP型晶体管,两种缺陷电荷分布对表面复合电流的影响如下:
| $ {I_{{\rm{bsr}}}} \propto {N_{{\rm{it}}}}/N_{{\rm{ot}}}^2 $ |
PNP型晶体管边缘电场分布如图 3所示。边缘电场模型[12]认为,发射结正偏时,由于空间电荷区变窄,边缘电场将被减弱,它的减小一方面会降低空穴的逃逸额,另一方面会降低由空穴运输所释放的质子浓度。正偏状态和零偏置状态相比,空穴逃逸额降低,沿电场输运到Si-SiO2界面的正电荷将减少,其体内的净正氧化物电荷和界面陷阱均减少。发射结反偏时恰与发射结正偏时情况相反,边缘电场将会增强,空穴逃离率也随之增加,与零偏状态相比,由空穴运输所释放的质子浓度将会增加,从而使得界面处的净正氧化物电荷和界面陷阱均增加,因此,在相同剂量率辐照下,由边缘电场Efr引起PNP晶体管退化在反偏时最显著,零偏次之,正偏最不敏感。
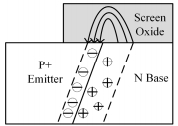
|
图 3 边缘电场Efr分布 Figure 3 Efr distribution of edge electric field |
同时,发射极上的金属电极产生的电场影响也应该加以考虑。PNP型晶体管由金属产生的电场Efr, m如图 4所示,正向偏置的基-射结电压会使Efr, m增加,这将有利于感生的正电荷输运到Si-SiO2界面处形成界面陷阱电荷,这与边缘电场引起的变化相反,但是PNP型晶体管的屏蔽氧化层较厚,故电场Efr, m并不是很高。因此,在与边缘电场的竞争中,边缘电场对于晶体管退化的影响更为明显。
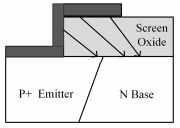
|
图 4 金属电极产生的电场Efr, m Figure 4 Distribution of electric field generated by the metal electrode Efr, m |
比较器LM339工作偏置时,Q1反向偏置而Q2正向偏置,而零偏时Q1、Q2处于零偏,器件的偏置效应取决于晶体管Q1、Q2的综合作用。器件制备的工艺偏差会使反偏状态下的器件Q1和正偏状态下的器件Q2对电离辐射敏感性不同,从而导致不同工作状态下比较器的输入偏置电流退化程度不同。对于该批次的LM339,可以推测一正一反两种偏置晶体管的辐射损伤程度小于两个晶体管都是零偏的情况。
2.2 开环增益由差模输入电压引起的对地输出电压与此差模输入电压之比,即为开环增益。这是信号电压从输入端到输出端传输过程中所表现出来的,与输入和输出电压同时有关的特征参数。在高低剂量率下的开环增益随总剂量及室温退火的变化如图 5所示。图 5中表明两种偏置下的开环增益均随着辐照总剂量的增加而减小,且低剂量率下零偏为最劣偏置。在随后的退火过程中开环增益发生微小的损伤恢复,随后趋于不变。通过高、低剂量率损伤趋势的对比,表明器件开环增益存在潜在的低剂量辐射损伤增强效应。
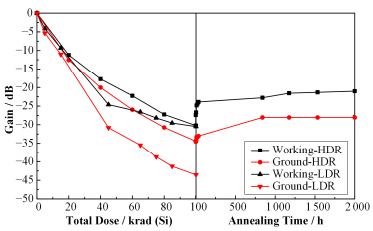
|
图 5 LM339在高低剂量率下开环增益的辐照响应和室温退火行为 Figure 5 Radiation response of open loop gain and room-temperature annealing time for LM339 with HDR and LDR |
由原理图 1可知,LM339电压比较器由差分输入级、中间放大器以及输出级三级结构级联构成。根据多级放大电路的放大倍数等于组成它的各级放大电路电压放大倍数之积,可知LM339电压比较器的总增益如式(1)所示,开环增益的辐射损伤可以通过输入级、中间级和输出级三级不同程度的退化来表示。
| $ A{v_{{\rm{total}}}} = A{v_{{\rm{input - stage}}}} \cdot A{v_{{\rm{amplifier - stage}}}} \cdot A{v_{{\rm{output - stage}}}} $ | (1) |
LM339电压比较器的输入级由Q1、Q3和Q2、Q4分别采用共集-共射形式。根据图 6、图 7的交流等效电路,易得输入级的电压增益为:
| $ A{v_{{\rm{input}}}} \approx \frac{{{\beta _2}{\beta _4}({R_{\pi 5}}//{R_{{\rm{O}}8}})}}{{{r_{{\rm{be}}4}} + (1 + {\beta _2}){r_{{\rm{be}}2}}}}\infty {\beta _4} \cdot {R_{\pi 5}} $ | (2) |
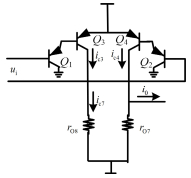
|
图 6 输入级交流通路 Figure 6 AC circuit of input stage |
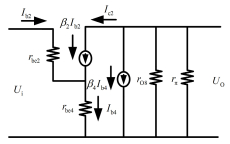
|
图 7 输入级交流等效电路 Figure 7 AC equivalent circuit of input stage |
式中:RO8为Q8的体电阻,
电离辐射引起双极晶体管增益β减小,随着累积剂量的增加,晶体管Q4的增益β4不断减小,同时由于输入偏置电流增大,输入阻抗也会随着累积剂量的积累而变小。因此,输入级增益的辐照损伤主要是由晶体管Q4的β4和中间级Q5的输入阻抗的不断退化而引起的。
2.2.2 中间级、输出级退化LM339电压比较器的中间级和输出级由Q5、Q6组成,其采用典型的共射形式。典型共射结构的小信号模型如图 8所示,Q5、Q6的输入阻抗可表示为:
| $ {r_\pi } = \frac{{{V_{{\rm{be}}}}}}{{{i_{\rm{b}}}}} $ | (3) |
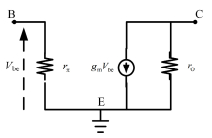
|
图 8 共射结构交流等效电路 Figure 8 Equivalent circuit of the common-emitter structure |
根据晶体管基极电流
| $ {r_\pi } = \frac{\beta }{{{g_{\rm{m}}}}} = \frac{\beta }{{38{I_{\rm{c}}}}} $ | (4) |
其中:根据晶体管的跨导以及理想PN结导通电流的微分形式,可得:
| $ \begin{array}{c} {g_{\rm{m}}} = \frac{{{\rm{d}}{I_{\rm{c}}}}}{{{\rm{d}}{V_{{\rm{be}}}}}} = \frac{{{\rm{d}}[\alpha {I_{\rm{s}}}\exp (q \cdot {V_{{\rm{be}}}}/KT)]}}{{{\rm{d}}{V_{{\rm{be}}}}}}\\ = \frac{q}{{KT}}{I_{\rm{c}}} \approx 38{I_{\rm{c}}} \end{array} $ | (5) |
共射结构的小信号模型,如图 8所示,其电压增益为
则中间级与输出级的增益为:
| $ \begin{array}{c} Av = {g_{{\rm{m}}5}} \cdot {r_{\pi 6}} \cdot {g_{{\rm{m}}6}} \cdot {R_{\rm{L}}}\\ = {g_{{\rm{m}}5}} \cdot \frac{{{\beta _6}}}{{{g_{{\rm{m}}6}}}} \cdot {g_{{\rm{m}}6}} \cdot {R_{\rm{L}}}\\ = {g_{{\rm{m}}5}} \cdot {\beta _6} \cdot {R_{\rm{L}}} \end{array} $ | (6) |
由式(5)可知,晶体管的跨导与其集电极电流成正比,Q5的集电极电流由恒流源提供,虽然电离辐照会引起电源电流的退化,但电源电流的减小是由多个恒流源综合的结果,单个恒流源的辐照损伤很小。因此,中间放大级Q5的退化对于整个开环增益退化的影响很小。输出级Q6的β6和负载与式(6)中的增益成正比,这意味着β6的退化会直接导致增益的减小,同时,不同的输出负载也会引起增益的变化。
输入级、中间级和输出级随累积剂量积累而呈现出的不同程度的退化,LM339开环增益的辐照损伤主要可以归结于输入级晶体管Q4和输出级晶体管Q6的增益随累积剂量不断的减小,而中间放大器由于恒流源的作用,其退化不会对电路的开环增益产生明显的影响。同时,比较器工作偏置时产生的损伤小于零偏状态时产生的损伤,其原因是在工作偏置时,晶体管Q4、Q5和Q6均处在正向偏置状态,它们在辐照环境中的退化程度均小于零偏时的情况。从而在宏观参数上表现出在相同的累积剂量下,比较器零偏下的开环增益退化大于工作状态下的增益退化。
2.3 输出低电平图 9为高、低剂量率辐照对LM339器件输出低电平VOL的影响。由图 9可见,两种偏置下的输出低电平均随辐照累积剂量而增大,低剂量率的辐照损伤均比高剂量率损伤严重,且低剂量率下零偏为最劣偏置。在进行与低剂量辐照时间相当的室温退火过程后,并没有消除高、低剂量率的损伤差异,表明器件输出低电平存在低剂量辐射损伤增强效应。
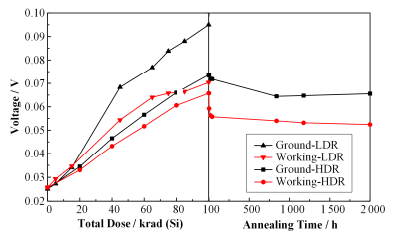
|
图 9 LM339在高低剂量率下输出低电平的辐照响应和室温退火行为 Figure 9 Radiation response of low-level output voltage and room-temperature annealing time for LM339 with HDR and LDR |
电路输出低电平的退化主要是由输出晶体管Q6退化引起的,这是因为当输出低电平时,晶体管Q5处于关断状态,此时晶体管Q6的基极电流由恒流源ISC2提供。根据Dussea等[6]研究,对于NPN型晶体管,基极电流Ib保持不变时,集电极电流Ic会随着辐照总剂量的增加而不断减小。由式(7),晶体管Q6的集电极电流Ic6不断退化,导致电路的输出低电平随总剂量的累积而增加。同时,可看出电路正偏状态下的损伤小于零偏置下的损伤,这是因为工作状态下晶体管Q6处于正偏,它的退化要小于零偏时的情况,从而表现出与开环增益相同的偏置效应。
| $ {V_{{\rm{OL}}}} = {V_{{\rm{cc}}}} - {I_{\rm{c}}}({Q_6}) \cdot {R_{\rm{L}}} $ | (7) |
比较器LM339输入偏置电流、开环增益和输出低电平,均表现出了低剂量率辐射损伤增强效应。根据双分子模型[13-14],如下过程和ELDRS有关:1)自由电子和空穴复合;2)自由电子与俘获空穴的复合;3)俘获的空穴释放氢;4)氢的二聚化;5)氢重新俘获。氧化层中氢的浓度及氧化层表面附近的硅键是否钝化共同影响着界面陷阱的形成和退火速率。
电离辐射引起双极器件的电参数退化,主要是由于辐射引起隔离氧化层中氧化物电荷Not和界面陷阱电荷Nit的增加。当器件受到电离辐射时,在氧化层会产生大量电子空穴对,在边缘电场的作用下,逃脱初始复合后的电子被快速地扫出氧化层,剩下的空穴则在氧化层内跳跃输运到SiO2-Si界面。而空穴在向界面运输过程中会产生氧化物电荷(Oxide Traps, Not)或质子(H+),H+在随后输运到界面形成界面陷阱(Interface Traps, Nit)。研究表明:大多数双极晶体管的低剂量率下的损伤主要受界面陷阱Nit的影响。氧化物缺陷Not和界面陷阱Nit产生方程如下:
| $ \equiv {\rm{Si}}-{\rm{Si}} \equiv + {\rm{p}} \to \equiv {\rm{S}}{{\rm{i}}^{\rm{ + }}}-{\rm{Si}} \equiv $ |
| $ \equiv {\rm{Si}} - {\rm{H}} + {{\rm{H}}^{\rm{ + }}} \to \equiv {\rm{S}}{{\rm{i}}^{\rm{ + }}} + {{\rm{H}}_{\rm{2}}} $ |
辐照感生陷阱的电荷过程可以大致分为(a)-(c)过程,即逃逸初始复合的空穴被氧化层中的缺陷俘获;空穴向界面运输过程中质子H+的释放;质子H+与界面处Si-H作用生成界面陷阱。在高剂量率下,在氧化物体内和界面附近SiO2一侧产生大量氧化物陷阱正电荷,即产生少量的深陷阱空穴(Eγ中心)和大量的亚稳态空穴(Eδ中心),这些亚稳态空穴参与电子的复合反应,过程(9)加强,减小了空穴浓度参与释放H的过程(10)。同时,自由电子也可以通过过程(12)减小SSiH+的浓度从而影响H的释放。
(a) 缺陷俘获空穴:
| $ {\rm{S}}_{{\rm{Si}}}^0 + {\rm{p}} \to {\rm{S}}_{{\rm{Si}}}^ + $ | (8) |
| $ {\rm{S}}_{{\rm{Si}}}^ + + {\rm{e}} \to {\rm{S}}_{{\rm{Si}}}^{} $ | (9) |
(b)质子的释放:
| $ {\rm{S}}_{{\rm{Si}}}^{}{\rm{H}} + {\rm{p}} \to {\rm{S}}_{{\rm{Si}}}^{}{{\rm{H}}^ + } $ | (10) |
| $ {\rm{S}}_{{\rm{Si}}}^{}{{\rm{H}}^ + } \to {\rm{S}}_{{\rm{Si}}}^{} + {{\rm{H}}^ + } $ | (11) |
| $ {\rm{S}}_{{\rm{Si}}}^{}{{\rm{H}}^ + } + {\rm{e}} \to {\rm{S}}_{{\rm{Si}}}^{}{\rm{H}} $ | (12) |
(c)界面陷阱的生成:
| $ {\rm{P}}_{\rm{b}}^{}{\rm{H}} + {{\rm{H}}^ + } \to {\rm{P}}_{\rm{b}}^ + + {{\rm{H}}_2} $ | (13) |
其中:p表示辐射感生空穴;
由于低剂量率辐照时,单位时间产生的电子空穴对相对较少,且自由电子在极短的时间内被扫至氧化层外,电子与正电荷的复合过程相对较弱。因此,相比较高剂量率条件下,低剂量率辐照时会有更多的质子(H+)释放并参与界面陷阱的生成,从而表现出对于恒定的总剂量,辐照损伤会随着剂量率的减小而增强。所以,双极电压比较器LM339表现出低剂量率辐射损伤增强效应。
4 结语综上所述,对PNP输入电压比较器LM339研究表明:
1) 输入偏置电流的增加主要是由输入级晶体管Q1、Q2产生的过剩电流引起的,它的偏置效应取决于输入级正偏状态下的器件和零偏状态下的器件对电离辐射的敏感度,其原因是不对称的加电方式,导致输入级晶体管分别处在正偏状态和零偏状态,输入偏置电流的退化恰是两个不同偏置状态晶体管的综合作用;开环增益的减小主要是由输入级晶体管Q4与输出级Q6晶体管发生不同程度的退化所引起,中间放大器由于恒流源的作用,其退化不会对电路的开环增益产生明显的影响;输出低电平的退化主要是由输出级晶体管Q6的损伤所引起的。
2) 输入偏置电流、开环增益和输出低电平敏感参数的低剂量率辐照损伤均比高剂量率辐照损伤显著,且室温退火并没有消除这种高低剂量率辐照损伤的显著差异。这是因为低剂量率辐照时,单位时间产生的电子空穴对相对较少,电子与正电荷的复合过程相对较弱,相比高剂量率条件,低剂量率辐照时会有更多的质子(H+)释放并参与界面陷阱的生成,致使辐照损伤会随着剂量率的减小而增强。
| [1] |
Fleetwood D M, Kosier S L, Nowlin R N, et al. Physical mechanisms contributing to enhanced bipolar gain degradation at low dose rates[J]. IEEE Transactions on Nuclear Science, 1994, 41(6): 1871-1883. DOI:10.1109/23.340519 |
| [2] |
Pershenkov V S, Belyakov V V, Shalnov A V. Fast switched-bias annealing of radiation-induced oxide-trapped charge and its application for testing of radiation effects in MOS structures[J]. IEEE Transactions on Nuclear Science, 1994, 41(6): 2593-2599. DOI:10.1109/23.340620 |
| [3] |
Enlow E W, Pease R L, Combs W, et al. Response of advanced bipolar processes to ionizing radiation[J]. IEEE Transactions on Nuclear Science, 1991, 38(6): 1342-1351. DOI:10.1109/23.124115 |
| [4] |
Pease R L, Adell P C, Rax B G, et al. The effects of hydrogen on the enhanced low dose rate sensitivity (ELDRS) of bipolar linear circuits[J]. IEEE Transactions on Nuclear Science, 2008, 55(6): 3169-3173. DOI:10.1109/TNS.2008.2006478 |
| [5] |
Pease R L, Maher M C, Shaneyfelt M R, et al. Total-dose hardening of a bipolar-voltage comparator[J]. IEEE Transactions on Nuclear Science, 2002, 49(6): 3180-3184. DOI:10.1109/TNS.2002.805404 |
| [6] |
Dusseau L, Bernard M F, Boch J, et al. Analysis of total-dose response of a bipolar voltage comparator combining radiation experiments and design data[J]. IEEE Transactions on Nuclear Science, 2006, 53(4): 1910-1916. DOI:10.1109/TNS.2006.880950 |
| [7] |
Krieg J F, Titus J L, Emily D, et al. Enhanced low dose rate sensitivity (ELDRS) in a voltage comparator which only utilizes complementary vertical NPN and PNP transistors[J]. IEEE Transactions on Nuclear Science, 1999, 46(6): 1616-1619. DOI:10.1109/23.819129 |
| [8] |
马武英, 陆妩, 郭旗, 等. 双极电压比较器电离辐射损伤及剂量率效应分析[J]. 物理学报, 2014, 63(2): 026101. MA Wuying, LU Wu, GUO Qi, et al. Analyses of ionization radiation damage and dose rate effect of bipolar voltage comparator[J]. Acta Physica Sinica, 2014, 63(2): 026101. DOI:10.7498/aps.63.026101 |
| [9] |
王义元, 陆妩, 任迪远, 等. 双极电压比较器不同条件下总剂量辐射效应[J]. 原子能科学技术, 2012, 46(9): 1147-1152. WANG Yiyuan, LU Wu, REN Diyuan, et al. Total ionizing dose effect of bipolar voltage comparator[J]. Atomic Energy Science and Technologe, 2012, 46(9): 1147-1152. |
| [10] |
马武英, 陆妩, 郭旗, 等. 双极电压比较器低剂量率辐照损伤增强效应的变温辐照加速评估方法[J]. 原子能科学技术, 2014, 48(11): 2170-2176. MA Wuying, LU Wu, GUO Qi, et al. Accelerated evaluation method of temperature switching irradiation for ELDRS of bipolar voltage comparator[J]. Atomic Energy Science and Technologe, 2014, 48(11): 2170-2176. DOI:10.7538/yzk.2014.48.11.2170 |
| [11] |
Pershenkov V S, Maslov V B, Cherepko S V, et al. The effect of emitter junction bias on the low dose-rate radiation response of bipolar devices[J]. Nuclear Science IEEE Transactions on, 1997, 44(6): 1840-1848. DOI:10.1109/23.658951 |
| [12] |
Pershenkov V S, Chirokov M S, Bretchko P T, et al. The effect of junction fringing field on radiation-induced leakage current in oxide isolation structures and nonuniform damage near the channel edges in MOSFETs[J]. IEEE Transactions on Nuclear Science, 1995, 41(6): 1895-1901. |
| [13] |
Hjalmarson H P, Pease R L, Devine R A B. Calculations of radiation dose-rate sensitivity of bipolar transistors[J]. IEEE Transactions on Nuclear Science, 2008, 55(6): 3009-3015. DOI:10.1109/TNS.2008.2007487 |
| [14] |
Hjalmarson H P, Pease R L, Witczak S C, et al. Mechanisms for radiation dose-rate sensitivity of bipolar transistors[J]. Nuclear Science IEEE Transactions on, 2004, 50(6): 1901-1909. DOI:10.1109/TNS.2003.821803 |


