电子学器件/电路通常使用重金属封装(如Kovar封装等)和互联工艺改善器件电学性能、提高常规可靠性,这些工艺在器件中引入高Z(Au、W等)/低Z(Si、SiO2)材料构成的界面(Z为原子序数),高Z材料对低能γ/X射线有较大的光电吸收截面,部分光电子穿过界面进入低Z材料区,引起辐射能量的不平衡输运,导致界面处低Z一侧产生剂量增强效应,使器件损伤超过与预期,常使用剂量增强因子(Dose Enhancement Factor, DEF)(增强因子=界面区域平均剂量/平衡剂量)表示剂量增强程度[1]。美国桑迪亚国家实验室(Sandia National Laboratories) [1]、中国工程物理研究院[2]、中国科学院新疆理化技术所[3]和西北核技术研究所[4]等已开展了理论计算和部分实验测量工作,研究典型界面区域的剂量分布,结果表明:低能γ/X射线辐照时剂量增强因子可达数十。
强钴源辐照装置是器件总剂量辐照实验常用设备,屏蔽墙、源包壳和束流通道壁等附属结构将产生低能散射γ,引起明显的剂量增强效应,影响器件耐辐照性能评估,这也是导致不同装置辐照考核结果差异的原因之一。强钴源辐射场γ注量率可达1011cm-2·s-1 (0.5Gy·s-1 (Si)),远超γ能谱仪计数率上限,研究机构多采用特制的剂量计系统,对比评价参量实测值与理想值的差异来评估低能γ成分是否过多。目前主要有两种实验评估方法:(Ⅰ)基于单/双层室壁积分式剂量计的评估方法,在单层室壁剂量计辐射敏感体外增设高Z覆层构造双层室壁剂量计,评价参量取为双层/单层室壁剂量计测量结果的比值;(Ⅱ)基于多膜平板电离室剂量计的评估方法,仿照典型器件界面结构,设置多个相互间隔的薄膜电极,电极辐射电流值对应界面区域相应位置的剂量,评价参量取为各电极辐射电流值与剂量平衡区电极辐射电流的比值。
方法(Ⅰ):使用的剂量计主要为热释光和MOSFET (Metal-Oxide-Semiconductor Field-Effect Transistor)[5-6]积分式剂量计(或γ敏感器件),优点是结构简易,但热释光剂量计量程低(几十Gy(Si)),MOSFET剂量计长期使用有一定的辐射损伤,且栅极对光电子的阻挡使其对DEF对能量低于300keV的γ不敏感,难以用于国家军用标准[7]要求的强钴源辐射场(0.5~3Gy·s-1 (Si))。方法(Ⅱ):使用多膜平板型电离室[4, 8-9],优点是能够用于强辐射场、可给出DEF随距离的变化情况,但探头涉及多张金属薄膜(数十微米)的加工及小间距(数毫米)装配,电流测量系统还需配置矩阵开关,探头加工难度较大、经济成本较高。此外,国家军用标准[7]建议使用铅铝容器抑制钴源低能散射γ,硬化辐射场能谱,但未给出容器壁厚设计依据,方法(Ⅰ)和(Ⅱ)也未对此进行讨论。
本文介绍了一种基于铝单层室壁/金铝双层室壁平板型电离室的散射γ成分实验评价方法,具备探头结构简易、适用于强60Co源辐射场和操作流程简单的特点,搭建了一套远距离辐射电流测量系统,在单板强钴源辐射场进行了验证实验。最后,探讨了两种电离室辐射电流比值与DEF的关系。
1 评价方法 1.1 原理根据空腔电离理论,空腔参数满足Bragg-Gray条件时,腔体中气体的电离量与室壁(吸收)剂量、腔体积成正比,室壁足够厚使空腔与室壁接触位置满足带电粒子平衡条件时,电离室辐射输出电流I可表征室壁材料平衡剂量。图 1给出了方法原理示意,1#和2#电离室分别使用低Z单层、低Z/高Z双层(或高Z单层)金属室壁材料,室壁兼作电极,对应的辐射输出电流分别为IL(低Z)和IH(高Z),设低能散射成分评价参量α=IH/IL,α取值依赖于γ能量。在特定能量范围内,若能谱形状偏离预期,使α明显变化,通过对比α实测与理想值的差异就能够估计这种偏离程度。为减小室壁材质及规格差异对辐射电流的影响,1#电离室壁内衬数十微米高Z薄层构造2#室壁。电离室选用结构简单的平板型,综合调节室壁厚度、空腔规格和电极电压等参数,使得辐射电流对剂量率的线性响应范围达到Gy·s-1(Si)量级,适用于强钴源辐射场。为减小加工误差影响,实际可只使用一套腔体支架,通过更换电极,分别构造1#和2#探头。

|
图 1 方法原理示意图 (a)辐射电流及电离室结构,(b)评价参量α随γ能量变化情况 Figure 1 The schematic diagram of method (a) γ-ray induced currents and structure of ionization chambers, (b) Evaluation parameter αvs. γ-ray energy |
1#电离室壁选为铝,2#室壁材料选为铝内衬金,原因如下:1)铝与硅的密度、γ质量能量吸收系数和电子射程都接近,两种材料剂量等效性较好,1#电离室经过标定后,能够用于评估体硅材料中的辐照剂量;2)金是器件常用材料(如Kovar封装),评价参量α和DEF(典型器件金-硅界面)对钴源散射γ的敏感性较为接近,可采用电镀或粘贴金属箔制备电极,避免方法(Ⅱ)中的薄膜装配步骤,简化探头制备。式(1)~(4)给出了α计算式[10]:
| $ \alpha {\rm{ = }}\frac{{{I_{{\rm{Au}}}}}}{{{I_{{\rm{Al}}}}}} $ | (1) |
| $ {I_{{\rm{Al}}}} = m{K_{{\rm{Al}}}}{D_{{\rm{Al}}}}\frac{{{R_{{\rm{Al}}}}}}{{{R_{{\rm{Air}}}}}} $ | (2) |
| $ {I_{{\rm{Au}}}} = m{K_{{\rm{Al}}}}{K_{{\rm{Au}}}}{D_{{\rm{Au}}}}\frac{{{R_{{\rm{Au}}}}}}{{{R_{{\rm{Air}}}}}} $ | (3) |
| $ m = 3.97 \times {10^{ - 8}}fAd $ | (4) |
式中:DAu、DAl分别为金和铝电极靠近空腔位置的剂量(率)和对应平衡剂量(率)值;RAu、RAl、RAir分别为电子在金、铝和空气中的射程,可用连续近似慢化射程代替;KAu、KAl分别为室壁金和铝层对γ射线的衰减系数,文中按窄束条件予以考虑,准确值可通过文献查阅或蒙特卡罗模拟计算获得;f为电离室的电荷搜集效率;A为电极面积;d为空腔厚度;m为剂量辐射电流转换系数,与电离室结构等参数有关。
MCNP (Monte Carlo N Particle Transport Code)是基于蒙特卡罗方法的通用软件包,可模拟电子、γ射线和中子在复杂几何中的输运过程,模拟准度已经通过诸多实验验证,广泛应用于辐照剂量学等领域。利用MCNP(版本5.1.14)模拟和式(1)分别计算单能γ辐照下的辐射电流比值α,结果见图 1(b)。由图 1分析可知,γ能量≥100keV和 < 100keV时,两种方法计算值的平均相对偏差分别为2.5%和16.5%,式(1)值偏大,究其原因可能是公式计算中未考虑电子射程对能量的依赖性,电极和空腔中电子射程的差异随能量减小而增大,即有室壁效应随γ能量减小而增大。总之,两种方法结果相符合;γ能量≤40keV,2#电离室金层屏蔽效果明显,辐射电流微弱,α趋于0;γ能量0.04~0.3MeV、0.3~0.6MeV、0.6~1MeV、1~1.25MeV,α取值范围分别为11.3~53.6、3.3~11.5、1.7~3.3、1.5(当Eγ=1.25MeV)~1.6。因此,α对钴源低能散射γ(约500keV以下)较为敏感,通过对比α实测值与参考值(αC)的差异,可评估低能量散射γ成分的比例是否过多。设Eγ≥EC时,器件无明显的剂量增强效应,αC由式(5)确定:
| $ {\alpha _{\rm{C}}}{\rm{ = }}\int\limits_{{E_{\rm{C}}}}^{1.25} {\alpha \left( {{E_{{\rm{ \gamma }}}}} \right)} f\left( {{E_{{\rm{ \gamma }}}}} \right){\rm{d}}{E_{\rm{\gamma }}} $ | (5) |
式中:Eγ为γ能量;EC为无明显剂量增强效应对应的γ能量下限;αC为辐射场是否满足使用要求的参考值;f归一化能谱分布,通常为未知分布。若实测α≤αC,说明γ能量集中在EC以上,即辐射场满足使用要求。
1.2 辐射电流比的参考值用式(5)分析典型能谱下αC的取值情况,能谱条件如下:1)由文献[3],Eγ≤300keV时,DEF较明显,取EC=300keV;2)设EC~1 MeV范围内的γ通量为F1,1~1.25MeV的γ通量为F2,则R= F2/F1表示较低能散射γ占比;3) 4种典型能谱形状见图 2,13种形状参量a、b和c组合取值见表 1。图 3给出了不同能谱下,αC对R的依赖关系,结果表明:αC取值范围1.75~4.52;αC随着R增大而减小;相较EC~1MeV具体分布而言,αC受R影响较大。
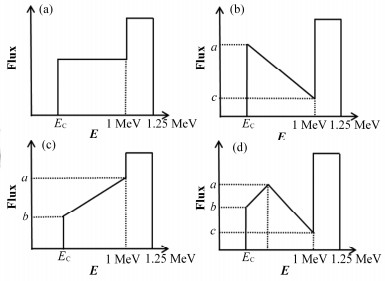
|
图 2 钴源辐射场典型能谱 (a)均匀分布,(b)低能占主,(c)高能占主,(d)一般情况 Figure 2 The typical energy spectrums of cobalt source irradiation field (a) Uniform distribution, (b) Low energy γ-rays taking up main part, (c) High energy γ-rays taking up main part, (d) Normal case |

|
图 3 不同能谱下,α对R的依赖关系 (a)情况1~5,(b)情况6~9,(c)情况10~13 Figure 3 αvs. R under the condition of different energy spectrums (a) Case 1~5, (b) Case 6~9, (c) Case 10~13 |
| 表 1 形状参量取值 Table 1 The values of shape parameters |
文献[10]给出Gamma Cell 220自屏蔽式照射器内腔(国外常用辐照装置,散射成分较多,属极劣化能谱)、单板钴源空场下R分别为1.02、4.1~4.4,对应图 3中取值2.35~3.36(仅图 2(b)谱情况 > 3)、1.9~2.3。一般而言,开放式辐照装置R≥2,对应αC≤2.8。
综上所述,铝单层室壁/金铝双层室壁平板型电离室辐射电流比值α对数百keV散射γ较为敏感,通过对比α实测值与参考值(αC=2.8)的差异,可评估低能散射γ (≤300keV)成分比例是否过多。
2 电离室和剂量计系统 2.1 电离室钴源辐射场γ大多在50keV以上[11-12],在铝和金中平衡电子能谱的平均能量也在50keV以上,空腔厚度取3mm(20keV电子连续慢化近似(Continuous Slowing Down Approximation, CSDA)射程约为7.5mm)足够满足Bragg-Gray条件。MCNP模拟结果表明:对钴源γ,单层铝壁厚1.2mm可获得铝材料平衡剂量,再内衬45μm金后可获得金材料平衡剂量。
电离室线性响应上限值受限于室壁(电极)对电荷的收集效率,通常要求收集效率0.95,下限为测量仪器的5~10倍,式(6)是电荷收集效率计算式[10],代入式(2)、(3)可获得电离室辐射电流值。
| $ f = \frac{1}{{1 + 2.7 \times {{10}^4}D{d^4}/{V^2}}} $ | (6) |
式中:D为空腔中的(吸收)剂量率;d为空腔厚度;V为电极电压;f为电荷收集效率。
电离室如图 4所示,参数为:空腔厚3mm;纯铝单层室壁(电极)厚1.2mm,金/铝双层室壁为1.2mm铝/45μm金;电极直径4cm,金膜采用化学电镀法制备,实测厚度不均匀性为15%,有待提高;用聚苯乙烯加工模体,作为支撑结构;用聚氨酯加工规定片,固定室壁(电极)。工作电压取100V时,本底电流值为(0.22±0.01)nA,由式(3)、(4),可知电离室量程为0.01~2.3Gy·s-1 (Si),满足器件辐照实验要求。
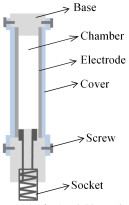
|
图 4 电离室结构示意图 Figure 4 The structure of ionization chamber |
电离室剂量计系统如图 5所示,组件和参数见表 2,主要包括5部分:静电计、恒压电源、线缆、接线盒和电离室探头。线缆为三同轴低损耗型,最外层金属作电磁屏蔽层用,线长40m时与10cm情况相比,本底电流无明显变化。串联多台恒压电源,可增大输出电压值。接线盒的纯铝外壳兼具电磁屏蔽作用。

|
图 5 电离室剂量计系统 Figure 5 Ionization chamber dosimeter system |
| 表 2 电离室剂量计系统的组件及参数 Table 2 The components and parameters of ionization chamber dosimeter system |
在设计装源量18.5PBq单板钴源辐射场进行实验[11],用重铬酸银化学剂量计标定辐射场剂量率。实验在空场条件和铅铝容器(散射抑制)内腔两种条件下进行,参考国家军用标准[7],铅外皮厚1.7mm,铝内层厚0.9mm。辐照实验布局如图 6所示,共进行两轮,分别在辐照室中部区的位置P1和P2进行,单轮实验中分步在空场中和容器内部进行,1#电离室为铝单层室壁电离室,2#为金铝双层室壁电离室。参考文献[12]同类辐射场、相似位置下R(图 3)分别为1.0(源附近,能谱单一性较好)、4.41(墙面附近,能谱劣化情况),能谱取表 1情况7,式(5)中积分下限取为200keV(铅厚1.7mm,能有效屏蔽200keV以下γ),铅铝容器内α取值范围分别为2.1~2.8、3.0~4.8,P1、P2都位于辐照室中部,散射情况介于文献[12]两种情况之间,预计α值接近3.0。
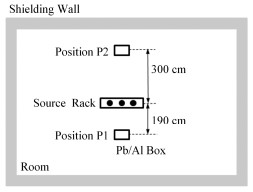
|
图 6 辐照实验布局(俯视) Figure 6 A top view of experiment layout |
表 3列出了辐射电流和评价参量实测结果,由分析可知:空场下,在P1、P2位置1#电离室辐射灵敏度分别为145 nC·Gy-1(Si)和158nC·Gy-1(Si),2#电离室辐射灵敏度分别为586nC·Gy-1(Si)和721nC·Gy-1(Si),P2位置靠墙较近,散射成分稍多,辐射灵敏度值和α都偏大;铅铝容器内部的辐射电流比值α明显小于空场条件,因此容器能够有效降低低能散射γ的比例;从数值来看,α实测与估计值相符;P1、P2位置的铅铝容器中α≤参考值(2.8),说明γ能量应集中在300keV~1.25MeV范围内,均适合用于器件辐照实验,可使用2~5mm厚铅层,进一步硬化能谱。上述实验结果都与预期情况相符合,说明评价方法是合适的。
| 表 3 辐射电流和评价参量实测值 Table 3 The experimental values of γ-ray induced current and evaluation parameter |
从两个方面进行对比:α与DEF的关系;α、DEF分别作归一化处理,即实际值除以理想钴源下的值,辐射电流比值相对值Rα和相对剂量增强因子RDEF的关系。前者关系到本文方法是否能较为准确给出界面区域(或器件)的实际剂量,后者的潜在应用是评估同一样品在不同辐射环境中的DEF是否一致。
文献[2, 13-15]利用蒙特卡罗计算,获得了4种情况下的DEF:0.1~2MeV γ辐照下W-SiO2界面0.2μm范围内、CMOS器件50nm厚栅氧区、W-Si界面1.2μm范围内以及Au-Si界面处的DEF。α由式(1)给出,图 7给出了上述DEF与α的对应关系。结合图 1和图 7,由分析可知:W-Si体系材料,在低能区(≤150keV),W对γ的衰减较大,使得DEF随α增加而减小,其余情况下,DEF随α增加单调增大;γ能量小于约400keV后,4种情况下的α和DEF都明显增大;对CMOS器件,硅栅可部分阻挡来自重金属封装的光电子,使得低能γ辐照下的DEF值明显较小;能量约在200keV以上γ辐照时,1.3μm封装层使得栅氧剂量小于平衡剂量,使得DEF小于1。由以上结果可推测,在钴源γ能量范围内,α和DEF有较好的单调关系,说明α对理想值的偏离程度能够反应实际剂量是否明显偏离平衡剂量,但器件实际剂量与结构相关,不能仅由α评定。
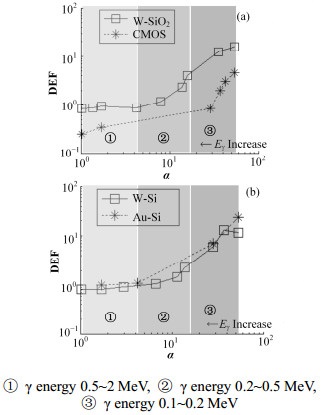
|
图 7 界面区域DEF对α的响应关系 (a) W-SO2和CMOS界面,(b) W-Si和Au-Si界面 Figure 7 DEF vs. α within regions near interface (a) W-SO2 and CMOS, (b) W-Si and Au-Si |
对图 7中数据进行归一化处理,结果见图 8,由分析可知:在γ能量1~2MeV,Rα与RDEF比值接近1;γ能量0.5~1MeV,Rα/RDEF > 1,随辐射能量减小而增大;γ能量0.2~0.3MeV,Rα/RDEF达到极大值,范围为2.5~7.1;γ能量0.1~0.2MeV,Rα与RDEF比值范围1.7~2.5,比值随辐射能量减小而趋于1。
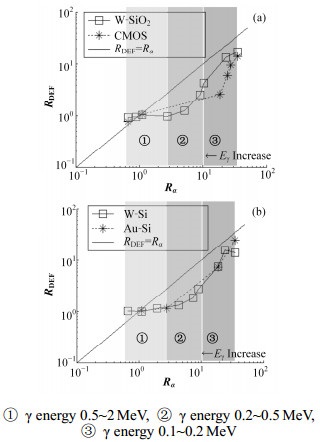
|
图 8 界面区域RDEF对Rα的响应关系 (a) W-SO2和CMOS界面,(b) W-Si和Au-Si界面 Figure 8 RDEF vs. Rα within regions near interface (a) W-SO2 and CMOS, (b) W-Si and Au-Si |
以上结果说明,Rα接近1,说明RDEF也接近1,若明显大于1,Rα可能高估RDEF。文献[16]实验结果说明CMOS 4069型(Kovar封装)器件在30~100keV连续能谱X射线辐照下的RDEF为6.0(零偏),本文Rα计算值为8.4,高估40%。
5 结果与讨论铝单层室壁/金铝双层室壁平板型电离室辐射电流比值α对(数十到数百keV)γ射线较为敏感,对比α实测值与参考值(建议取为2.8)的差异,可评估高剂量率(≥0.5Gy·s-1(Si))钴源辐射场低能散射γ (≤300keV)成分是否过多而导致明显的剂量增强效应。某单板工业钴源辐照装置附属结构件多、低能散射成分较多,空场下的α可达4.6,参照国家军用标准,使用铅铝容器抑制低能散射γ后,α减小到2.8,适用于器件辐照实验,方法可检验能谱硬化技术的有效性。
对于Kovar等重金属封装器件而言,α和DEF对辐射能量的依赖关系相似,γ能量≤400keV后,α和DEF都明显增大(以钴源γ为参考),α能够反应DEF是否明显偏大。进一步,若两个辐射场α接近,则器件DEF和实际辐照剂量都接近,这一结论有助于从剂量角度关联不同辐射场或相同辐射场的不同辐照工位。
本文方法的特点是适用于强钴源辐射场、流程简单、探头易加工、方便现场使用,不足之处在于针对钴源辐射场,定性评价低能散射成分/器件DEF是否会明显过多/偏大,尚不能给出实际能谱/器件实际辐照剂量值。对未知能谱的高剂量率辐射场而言,准确评估器件实际辐照剂量是较为困难的,应当发展强辐射场能谱评价方法,一种可期的实测方法是:设计不同能量响应特性的系列剂量计,利用已知的能量曲线对剂量测试结果进行拟合,给出辐射场能谱。
| [1] |
Simons M, Fleetwood D M, Schwank J R, et al. Dose enhancement in a room cobalt-60 source (SAND-97-0424C)[R]. Sandia National Laboratories, Albuquerque, NM, United States, 1997.
|
| [2] |
牟维兵, 陈盘训. X射线在重金属-二氧化硅界面的剂量增强的模拟计算[J]. 强激光与粒子束, 2001, 13(1): 15-18. MU Weibing, CHEN Panxun. Simulative calculation of the dose enhancement factor of W-SiO2 and Ta-SiO2 interface[J]. High Power Laser and Particle Beams, 2001, 13(1): 15-18. |
| [3] |
吴正新, 何承发, 陆妩, 等. X射线对金硅界面剂量增强效应的模拟研究[J]. 核技术, 2013, 36(6): 060201. WU Zhengxin, HE Chengfa, LU Wu, et al. Monte Carlo simulation of dose enhancement effect of X-ray at Au/Si interface[J]. Nuclear Techniques, 2013, 36(6): 060201. DOI:10.11889/j.0253-3219.2013.hjs.36.060201 |
| [4] |
郭红霞. X射线、γ射线引起不同界面材料剂量增强效应的测量及理论模拟[D]. 西安: 西安电子科技大学, 2002. GUO Hongxia. Numerical simulation of ionizing radiation effects and study on the X-ray and γ-ray dose enhancement effects for integrated circuit[D]. Xi'an: Xidian University, 2002. |
| [5] |
Simons M, Pease R L, Fleetwood D M, et al. Dose enhancement in room cobalt-60 source[J]. IEEE Transactions on Nuclear Science, 1997, 44(6): 2052-2057. DOI:10.1109/23.658990 |
| [6] |
郭红霞, 陈雨生, 张义门, 等. 双层膜结构测量CMOS器件X射线相对剂量增强因子及其理论模拟[J]. 核电子学与探测技术, 2002, 22(1): 47-51. GUO Hongxia, CHEN Yusheng, ZHANG Yimen, et al. Measurement of X-ray relative dose-enhancement factor for CMOS device using bi-laminate structure and its simulation[J]. Nuclear Electronics & Detection Technology, 2002, 22(1): 47-51. |
| [7] |
中华人民共和国国家军用标准. GJB 548B-2005: 微电子器件试验方法和程序[S]. 2005. People's Republic of China National Military Standard. GJB 548B-2005: Test methods and procedures for microelectronic device[S]. 2005. |
| [8] |
Wall J A, Burke E A. Dose distributions at and near the interface of different materials exposed to cobalt-60 gamma radiation[R]. Air Force Cambridge Research Laboratories, AD-A010 427, 1975. https://www.researchgate.net/publication/234243894_Dose_distributions_at_and_near_the_interface_of_different_materials_exposed_to_cobalt-60_gamma_radiation
|
| [9] |
何承发, 巴维真, 吴勤之, 等. 60Co γ射线在界面附近金中的剂量分布[J]. 核技术, 1997, 20(3): 143-147. HE Chengfa, BA Weizhen, WU Qinzhi, et al. Dose profiles of 60Co gamma rays in gold near interfaces with other materials[J]. Nuclear Techniques, 1997, 20(3): 143-147. |
| [10] |
Attix F H, 著. 雷家荣, 崔高显, 译. 放射物理和辐射计量学导论[M]. 北京: 北京原子能出版社, 2013: 178-266. Attix F H, ed. LEI Jiarong, CUI Gaoxian, tran. Introduction to radiology and radiation metrology[M]. Beijing: Beijing Atomic Energy Publishing House, 2013: 178-266. |
| [11] |
李磊, 李晓燕, 蒋树斌, 等. 基于改进型贪心算法的单板源源棒排列优化[J]. 核技术, 2015, 38(10): 100204. LI Lei, LI Xiaoyan, JIANG Shubin, et al. Optimization of source pencil deployment of single-plate irradiation facility based on improved greedy algorithm[J]. Nuclear Techniques, 2015, 38(10): 100204. DOI:10.11889/j.0253-3219.2015.hjs.38.100204 |
| [12] |
美国材料与试验协会. 使用Co-60源的硅电子设备的辐射硬性试验的最小剂量测定错误标准规程[S]. ASTM E1249-2000(2005), 2005. American Society for Testing and Materials. Standard practice for minimizing dosimetry errors in radiation hardness testing of silicon electronic devices using Co-60 sources[S]. ASTM E1249-2000(2005), 2005. |
| [13] |
牟维兵, 徐曦. 剂量增强理论计算与实验测量[C]. 中国工程物理研究院第七届电子技术青年学术交流会, 绵阳, 2005. MU Weibing, XU Xi. Calculation and experimental measurement of dose enhancement factor[C]. The 7th Young Academic Communication in Electronic Techniques of CAEP, Mianyang, 2005. |
| [14] |
牟维兵, 陈盘训. 电子器件不同材料界面对X射线的响应[C]. 第11届全国核电子学与核探测技术学术年会, 厦门, 2002. MU Weibing, CHEN Panxun. The X-ray response near the different interface of electronic devices[C]. The Proceeding of 11th National Academic Annual Reference in Nuclear Electronics and Nuclear Detection Technology, Xiamen, 2002. |
| [15] |
周银行, 马玉刚. 金属-Si界面剂量增强效应的模拟研究[J]. 核电子学与探测技术, 2009, 23(5): 1012-1016. ZHOU Yinhang, MA Yugang. Monte Carlo simulation of dose enhancement effect of semiconductor-metal interface[J]. Nuclear Electronics & Detection Technology, 2009, 23(5): 1012-1016. |
| [16] |
郭红霞, 陈雨生, 张义门, 等. 稳态、瞬态X射线辐照引起的互补性金属氧化物半导体器件剂量增强效应研究[J]. 物理学报, 2001, 50(12): 2279-2283. GUO Hongxia, CHEN Yusheng, ZHANG Yimen, et al. Study of relative dose-enhancement effects on CMOS device irradiated by steady-state and transient pulsed X-rays[J]. Acta Physica Sinica, 2001, 50(12): 2279-2283. DOI:10.3321/j.issn:1000-3290.2001.12.001 |
